TSMC đang tăng đầu tư ở Đài Loan và Mỹ để xử lý điểm nghẽn lớn nhất của chuỗi cung ứng chip AI: advanced packaging, tức khâu ghép die, bộ nhớ HBM và đế kết nối thành gói chip hoàn chỉnh cho máy chủ. Với GPU AI đời mới, chip có sản xuất xong vẫn chưa thể giao nếu không đi qua các công nghệ đóng gói như CoWoS hay SoIC. Theo bài viết của Wccftech, TSMC hiện muốn mở thêm năng lực ở cả hai bờ Thái Bình Dương thay vì chỉ tăng fab logic. Điều này đáng chú ý vì khi khâu đóng gói bị nghẽn, toàn bộ nhịp mở rộng máy chủ AI cũng chậm theo.
Vì sao advanced packaging của TSMC đang trở thành nút thắt thật sự của AI?
Advanced packaging có thể hiểu ngắn gọn là bước biến các thành phần đã sản xuất riêng lẻ thành một khối chip mật độ cao có thể hoạt động như một hệ thống thống nhất. Với chip AI, đây là nơi GPU phải đi cùng HBM qua các kết nối rất ngắn để đạt băng thông đủ lớn. Khi kích thước gói chip tăng nhanh qua từng thế hệ, phần đóng gói không còn là bước cuối mang tính thủ tục mà trở thành giới hạn của tốc độ giao hàng. Có wafer nhưng thiếu CoWoS hoặc SoIC thì chip AI vẫn chưa thể ra thị trường đúng kế hoạch.
Theo nguồn tin CNA được bài gốc dẫn lại, TSMC muốn trang bị CoWoS, WMCM và SoIC cho 7 cơ sở tại Đài Loan, đồng thời cân nhắc chuyển một số fab 8-inch cũ sang phục vụ đóng gói tiên tiến. Báo cáo này cho rằng năng lực đầu ra tương đương có thể tăng từ khoảng 1,3 triệu lên 2 triệu wafer vào năm 2027. Chi tiết đó cho thấy bài toán AI lúc này không chỉ là tiến trình bao nhiêu nanomet, mà là mở công suất ở đúng khâu đang tắc.
Tác động đã lan ra toàn chuỗi cung ứng. Khi một nhà đúc giữ phần lớn năng lực đóng gói tiên tiến, khách hàng từ GPU, ASIC đến chip máy chủ tùy biến đều bị kéo vào cùng một hàng chờ. Đó cũng là lý do những câu chuyện như TSMC độc quyền chip AI không chỉ liên quan tới thị phần foundry, mà còn gắn trực tiếp với tốc độ giao phần cứng cho trung tâm dữ liệu.
Đầu tư mới ở Đài Loan và Arizona sẽ thay đổi gì cho máy chủ AI?
Ở Mỹ, TSMC được cho là đầu tư thêm hai cơ sở advanced packaging tại Arizona và hướng tới sản xuất hàng loạt từ năm 2030. Khi năng lực AP xuất hiện ngay gần nơi sản xuất wafer, các fab tại Mỹ sẽ bớt phụ thuộc vào việc đưa chip về châu Á để hoàn thiện. Điều đó có thể rút ngắn thời gian giao hàng, giảm rủi ro logistics và giúp lịch triển khai máy chủ AI dễ dự báo hơn. Với các hãng cloud và OEM, đây là thay đổi mang tính vận hành chứ không chỉ là thêm công suất trên giấy.
| Điểm nghẽn | Tác động | Bước đi của TSMC |
|---|---|---|
| Thiếu CoWoS, SoIC | Chip AI hoàn thiện chậm | Mở AP tại 7 cơ sở ở Đài Loan |
| Đóng gói xa fab wafer | Tăng thời gian và rủi ro logistics | Đầu tư 2 cơ sở AP ở Arizona |
| Nhu cầu AI tăng quá nhanh | Cloud và OEM phải tranh công suất | Hướng tới 2 triệu wafer vào 2027 |
Nếu nút thắt này được nới bớt, áp lực lên các mắt xích khác như bộ nhớ HBM, module máy chủ và tiến độ triển khai cụm AI cũng sẽ dễ kiểm soát hơn. Điều đó liên quan trực tiếp tới những cảnh báo gần đây về giá bộ nhớ AI, bởi chi phí thường leo thang mạnh nhất khi nhiều điểm nghẽn xuất hiện cùng lúc.
Quan trọng hơn, đây là câu chuyện có tác động rất thật tới lịch ra hàng của cả thị trường máy chủ. Khi một mắt xích chậm lại, các hãng lắp ráp, nhà cung cấp linh kiện phụ trợ và đơn vị triển khai trung tâm dữ liệu đều phải điều chỉnh kế hoạch theo. Với người theo dõi ngành bán dẫn, chi tiết này giúp giải thích vì sao nhiều công bố mở rộng cụm AI nghe rất lớn nhưng vẫn mất nhiều quý mới chuyển thành năng lực vận hành thực tế.
Nhìn rộng hơn, TSMC đang phát tín hiệu rằng advanced packaging đã trở thành năng lực chiến lược của AI hạ tầng, không còn là phần hậu cần đứng sau fab. Nếu kế hoạch ở Đài Loan và Arizona đi đúng tiến độ, thị trường có thể bớt căng hơn ở khâu giao chip máy chủ trong vài năm tới.


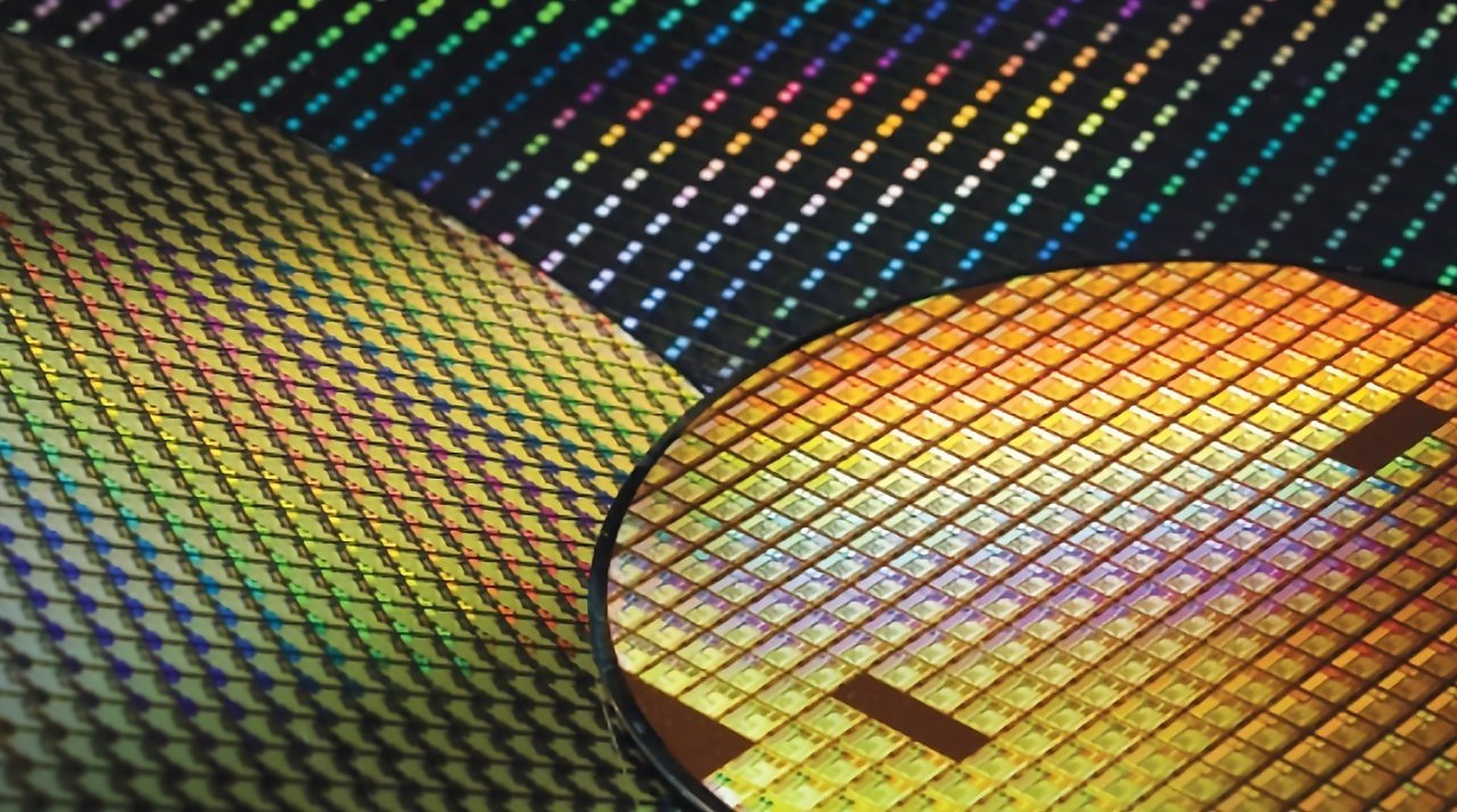
1 bình luận về “TSMC advanced packaging: muốn gỡ nút thắt AI bằng đầu tư mới ở Đài Loan và Mỹ”